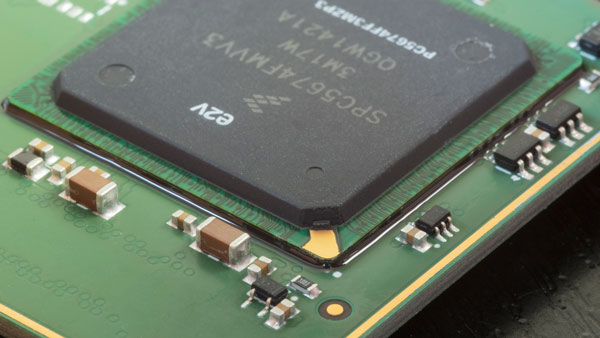
Underfill in Surface Mount Technology (SMT) involves applying a composite material based on an epoxy polymer with a significant amount of filler and agents between a chip and the substrate to fill any gaps. This process enhances mechanical strength and reliability by reducing stress on solder joints caused by thermal expansion and vibration.
Underfill also improves thermal cycling performance, prevents moisture ingress, and mitigates the risk of solder joint failure, thereby extending the lifespan of electronic components. It's crucial in applications requiring high durability and robust performance.

Essemtec is launching its latest machine: The Tarantula Underfill. An Innovative Solution to perform underfill process accurately, precisely & efficiently.
Tarantula Underfill Benefits
- Non-contact heating: Supports double-sided populated boards for the underfill
- Uniform temperature: 50-90°C
- Adaptable to different PCB sizes
- Large board capacity: up to 560 x 610 mm
- Piezo jet valve and time pressure valve available
- All known dispensing capabilities, valves and options of Tarantula available
Watch the underfill process video